실리콘 웨이퍼와 유리 웨이퍼는 모두 "세척"이라는 공통된 목표를 가지고 있지만, 세척 과정에서 직면하는 어려움과 고장 유형은 매우 다릅니다. 이러한 차이는 실리콘과 유리의 고유한 재료 특성 및 사양 요구 사항뿐만 아니라 최종 응용 분야에 따른 세척 "철학"의 차이에서 비롯됩니다.
먼저, 무엇을 청소하는 것인지, 어떤 오염물질을 제거하는 것인지 명확히 해봅시다.
오염물질은 네 가지 범주로 분류할 수 있습니다.
-
입자 오염 물질
-
먼지, 금속 입자, 유기 입자, 연마 입자(CMP 공정에서 발생) 등
-
이러한 오염 물질은 단락이나 개방 회로와 같은 패턴 결함을 유발할 수 있습니다.
-
-
유기 오염 물질
-
감광성 레지스트 잔류물, 레진 첨가제, 인체 피부 유분, 용제 잔류물 등이 포함됩니다.
-
유기 오염 물질은 에칭이나 이온 주입을 방해하는 마스크를 형성하고 다른 박막의 접착력을 저하시킬 수 있습니다.
-
-
금속 이온 오염물질
-
철, 구리, 나트륨, 칼륨, 칼슘 등은 주로 장비, 화학 물질 및 사람과의 접촉에서 발생합니다.
-
반도체에서 금속 이온은 금지대역에 에너지 준위를 도입하여 누설 전류를 증가시키고, 전하 운반체 수명을 단축시키며, 전기적 특성을 심각하게 손상시키는 "치명적인" 오염 물질입니다. 유리에서는 후속 박막의 품질과 접착력에 영향을 미칠 수 있습니다.
-
-
천연 산화막
-
실리콘 웨이퍼의 경우, 공기 중에서 표면에 얇은 이산화규소(자연산화물) 층이 자연적으로 형성됩니다. 이 산화물 층의 두께와 균일성을 제어하기 어렵기 때문에 게이트 산화막과 같은 핵심 구조를 제작할 때는 이 층을 완전히 제거해야 합니다.
-
유리 웨이퍼의 경우: 유리 자체는 실리카 네트워크 구조이므로 "자연 산화막 제거" 문제는 발생하지 않습니다. 그러나 표면이 오염으로 인해 변형되었을 수 있으며, 이 층은 제거해야 합니다.
-

I. 핵심 목표: 전기적 성능과 물리적 완벽성 간의 차이점
-
실리콘 웨이퍼
-
세척의 핵심 목표는 전기적 성능을 보장하는 것입니다. 일반적으로 요구되는 사양에는 엄격한 입자 수 및 크기 기준(예: 0.1μm 이상의 입자는 효과적으로 제거해야 함), 금속 이온 농도 기준(예: Fe, Cu는 10¹⁰ atoms/cm² 이하로 제어해야 함), 그리고 유기 잔류물 수준 기준이 포함됩니다. 미세한 오염조차도 회로 단락, 누설 전류 또는 게이트 산화막 손상으로 이어질 수 있습니다.
-
-
유리 웨이퍼
-
기판으로서의 핵심 요구 사항은 물리적 완벽성과 화학적 안정성입니다. 사양은 긁힘이나 제거 불가능한 얼룩이 없어야 하고, 원래의 표면 거칠기와 형상을 유지해야 하는 등 거시적인 측면에 중점을 둡니다. 세척의 주된 목적은 시각적으로 깨끗한 상태를 확보하고 코팅과 같은 후속 공정을 위한 우수한 접착력을 보장하는 것입니다.
-
II. 물질의 본질: 결정질과 비정질의 근본적인 차이
-
규소
-
실리콘은 결정질 물질이며, 표면에는 자연적으로 불균일한 이산화규소(SiO₂) 산화층이 형성됩니다. 이 산화층은 전기적 성능에 악영향을 미칠 수 있으므로 철저하고 균일하게 제거해야 합니다.
-
-
유리
-
유리는 비정질 실리카 네트워크입니다. 유리의 벌크 재료는 실리콘의 산화규소층과 구성이 유사하여 불산(HF)에 의해 빠르게 에칭될 수 있으며, 강알칼리 침식에도 취약하여 표면 거칠기 증가 또는 변형을 초래할 수 있습니다. 이러한 근본적인 차이로 인해 실리콘 웨이퍼 세척은 오염 물질 제거를 위한 가볍고 제어된 에칭을 견딜 수 있는 반면, 유리 웨이퍼 세척은 기본 재료 손상을 방지하기 위해 극도로 주의해서 수행해야 합니다.
-
| 청소용품 | 실리콘 웨이퍼 세척 | 유리 웨이퍼 세척 |
|---|---|---|
| 청소 목표 | 자체적인 천연 산화막 층을 포함합니다. | 세척 방법을 선택하십시오: 바탕 재료를 보호하면서 오염 물질을 제거합니다. |
| 표준 RCA 청소 | - SPM(H₂SO₄/H₂O₂): 유기물/포토레지스트 잔류물을 제거합니다. | 주요 청소 흐름: |
| - SC1(NH₄OH/H₂O₂/H₂O): 표면 입자를 제거합니다. | 약알칼리성 세척제활성 계면활성제를 함유하여 유기 오염물질 및 입자를 제거합니다. | |
| - 디히프(불화수소산): 천연 산화막 및 기타 오염 물질을 제거합니다. | 강알칼리성 또는 중알칼리성 세척제금속성 또는 비휘발성 오염 물질을 제거하는 데 사용됩니다. | |
| - SC2(염산/과산화수소/물): 금속 오염물질을 제거합니다. | HF를 피하십시오. | |
| 주요 화학 물질 | 강산, 강염기, 산화성 용매 | 약한 알칼리성 세척제로, 가벼운 오염 제거를 위해 특별히 제조되었습니다. |
| 물리적 보조 장치 | 탈이온수 (고순도 헹굼용) | 초음파, 메가소닉 세척 |
| 건조 기술 | 메가소닉, IPA 증기 건조 | 부드러운 건조: 천천히 들어 올리고 IPA 증기로 건조 |
III. 세척액 비교
앞서 언급한 목표와 재료 특성에 따라 실리콘 및 유리 웨이퍼용 세척 용액은 서로 다릅니다.
| 실리콘 웨이퍼 세척 | 유리 웨이퍼 세척 | |
|---|---|---|
| 청소 목표 | 웨이퍼의 자연 산화막 층을 포함하여 철저하게 제거합니다. | 선택적 제거: 기질을 보호하면서 오염 물질을 제거합니다. |
| 일반적인 과정 | 표준 RCA 클린:•SPM(H₂SO₄/H₂O₂): 무거운 유기물/포토레지스트 제거 •SC1(NH₄OH/H₂O₂/H₂O): 알칼리성 입자 제거 •디히프(희석된 HF): 자연 산화막과 금속을 제거합니다.SC2(HCl/H₂O₂/H₂O): 금속 이온을 제거합니다. | 일반적인 청소 흐름:•약알칼리성 세척제유기물과 미립자를 제거하는 계면활성제 함유 •산성 또는 중성 세척제금속 이온 및 기타 특정 오염 물질 제거용 •전체 과정에서 HF를 피하십시오. |
| 주요 화학물질 | 강산, 강산화제, 알칼리 용액 | 약알칼리성 세척제; 특수 중성 또는 약산성 세척제 |
| 신체적 지원 | 메가소닉(고효율, 부드러운 입자 제거) | 초음파, 메가소닉 |
| 건조 | 마랑고니 건조; IPA 증기 건조 | 저속 건조; IPA 증기 건조 |
-
유리 웨이퍼 세척 공정
-
현재 대부분의 유리 가공 공장에서는 유리의 재질 특성에 기반한 세척 절차를 사용하며, 주로 약알칼리성 세척제를 사용합니다.
-
세척제 특성:이러한 특수 세척제는 일반적으로 pH 8~9 정도의 약알칼리성입니다. 이들은 대개 계면활성제(예: 알킬 폴리옥시에틸렌 에테르), 금속 킬레이트제(예: HEDP), 그리고 유기 세척 보조제를 함유하고 있으며, 기름이나 지문과 같은 유기 오염 물질을 유화 및 분해하는 동시에 유리 기판에 대한 부식성을 최소화하도록 설계되었습니다.
-
프로세스 흐름:일반적인 세척 공정은 상온에서 60°C 범위의 온도에서 특정 농도의 약알칼리성 세척제를 사용하고 초음파 세척을 병행하는 방식으로 진행됩니다. 세척 후 웨이퍼는 순수로 여러 번 헹구고, 서서히 건조하는 방식(예: 저속 리프팅 또는 IPA 증기 건조)을 거칩니다. 이 공정은 유리 웨이퍼의 육안 청결도 및 전반적인 청결도 요구 사항을 효과적으로 충족합니다.
-
-
실리콘 웨이퍼 세척 공정
-
반도체 공정에서 실리콘 웨이퍼는 일반적으로 표준 RCA 세척을 거칩니다. RCA 세척은 모든 유형의 오염 물질을 체계적으로 제거할 수 있는 매우 효과적인 세척 방법으로, 반도체 소자의 전기적 성능 요구 사항을 충족합니다.
-
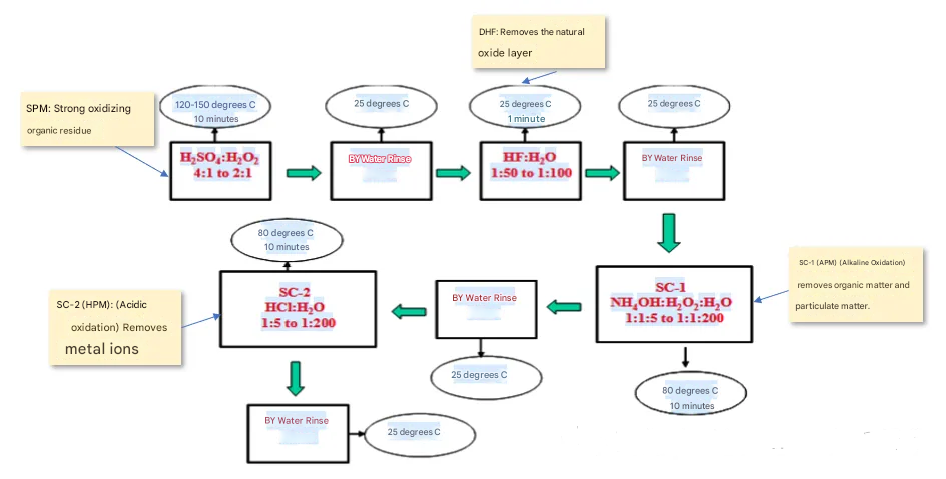
IV. 유리가 더 높은 "청결도" 기준을 충족할 때
엄격한 입자 수 및 금속 이온 농도 기준이 요구되는 응용 분야(예: 반도체 공정의 기판 또는 우수한 박막 증착 표면)에서 유리 웨이퍼를 사용할 경우, 기존의 세척 공정만으로는 충분하지 않을 수 있습니다. 이러한 경우, 반도체 세척 원리를 적용하여 변형된 RCA 세척 전략을 도입할 수 있습니다.
이 전략의 핵심은 유리의 민감한 특성을 고려하여 표준 RCA 공정 매개변수를 희석하고 최적화하는 것입니다.
-
유기 오염물질 제거:SPM 용액이나 보다 약한 오존수는 강력한 산화 작용을 통해 유기 오염 물질을 분해하는 데 사용할 수 있습니다.
-
입자 제거:고도로 희석된 SC1 용액은 낮은 온도와 짧은 처리 시간에서 사용되어 정전기적 반발력과 미세 에칭 효과를 활용하여 입자를 제거하는 동시에 유리의 부식을 최소화합니다.
-
금속 이온 제거:희석된 SC2 용액 또는 단순 희석 염산/희석 질산 용액은 킬레이션 반응을 통해 금속 오염 물질을 제거하는 데 사용됩니다.
-
엄격히 금지되는 사항:유리 기판의 부식을 방지하기 위해 DHF(불화이암모늄)는 절대적으로 피해야 합니다.
개선된 전체 공정에서 메가소닉 기술을 결합함으로써 나노 크기 입자의 제거 효율이 크게 향상되고 표면에 미치는 손상도 줄어듭니다.
결론
실리콘 및 유리 웨이퍼의 세척 공정은 최종 응용 분야 요구 사항, 재료 특성, 물리적 및 화학적 특성을 기반으로 한 역설계의 필연적인 결과입니다. 실리콘 웨이퍼 세척은 전기적 성능을 위해 "원자 수준의 청결도"를 추구하는 반면, 유리 웨이퍼 세척은 "완벽하고 손상되지 않은" 물리적 표면을 얻는 데 중점을 둡니다. 반도체 응용 분야에서 유리 웨이퍼의 사용이 증가함에 따라, 유리 웨이퍼 세척 공정은 기존의 약알칼리성 세척을 넘어 더욱 정교하고 맞춤화된 솔루션, 예를 들어 변형된 RCA 공정과 같은 기술로 발전하여 더 높은 청결도 기준을 충족하게 될 것입니다.
게시 시간: 2025년 10월 29일
